WBE10X系列半自动晶圆键合机
应用场景:
适用于200mm和300mm晶圆键合产线;
配合光键公司的对准机使用,可以获得优秀的键合表现;
用于CIS,SiC功率器件,IGBT临时键合,金属键合等应用领域;
不仅适用于科研院所的实验,也适用于成熟产线的批量作业;
基于windows用户界面;
支持两种作业模式:半自动,手动;

WAE10X系列半自动晶圆对准机
应用场景:
适用于200mm和300mm晶圆键合产线;
用于3D互联、晶圆级封装和大容量MEMS器件的晶圆堆叠;
采用face-to-face的对准方式;
在对准过程中,镜头无需Z轴运动调焦;
基于windows用户界面;
在进入键合腔体之前,利用键合夹具实现晶圆的固定;
支持两种作业模式:半自动,手动;

WDE10X系列半自动晶圆解键合机
应用场景:
适用于150mm、200mm晶圆键合产线;
采用热滑移的方式,对减薄晶圆进行解键合;
采用上下加热盘独立加热的方式;
利用辅助载片/载板,协助完成作业;
具有上下真空吸盘,实现对待键合片上下面的吸附;
高精度的垂向位置控制系统;
控制架构为Windows+PLC双层控制系统;
支持两种作业模式:半自动,手动;
临时键合系列
-

WDB10X系列全自动解键合机
应用场景:
适用于200mm/300mm晶圆全自动临时键合产线;
具有EFEM自动化模块;
采用热滑移的方式,对减薄晶圆进行解键合;
利用辅助载片/载板,协助完成作业;
高精度的垂向位置控制系统;
可根据客户要求配置清洗单元;
控制架构为Windows+PLC双层控制系统;
支持三种作业模式:全自动,半自动,手动;

WTB10X系列全自动临时键合机
应用场景:
适用于200mm/300mm晶圆全自动临时键合产线;
具有EFEM自动化模块;
具有晶圆Flip功能;
采用多种对准方式;
具有涂胶、烘烤单元;
可根据客户需求配置键合腔数量;
控制架构为Windows+PLC双层控制系统;
支持三种作业模式:全自动,半自动,手动;
激光键合系列
-

LCB-X-100系列激光压力键合机
应用场景:
芯片与芯片键合,芯片与基板键合,芯片与晶圆键合,尤其对于大尺寸,超大尺寸芯片键合具有优异的性能表现。
可广泛用于红外传感器、MicroLED、AI芯片的生产制造。
提供Compress解决方案;
具有贴片、拾片集成解决方案;
基于windows用户界面;
支持两种作业模式:半自动,手动

LAB-S-100系列激光辅助键合机
应用场景:
芯片与芯片键合,芯片与基板键合,芯片与晶圆键合,尤其对于大尺寸,超大尺寸芯片键合具有优异的性能表现。
可广泛用于红外传感器、MicroLED、AI芯片的生产制造。
基于LAB-X-100系列进行升级;适用于FCBGA产线的应用;
具有贴片、拾片集成解决方案;
支持轨道传输系统;
具有温度CT成像功能;
基于windows用户界面;
支持两种作业模式:半自动,手动;

LAB-X-100系列激光辅助键合机
应用场景:
适用于R&D,高校实验室等研发;
更经济的产线升级模式;
光斑支持10*10mm ~ 50*50mm;
可选配轨道传输系统;
可选配晶圆键合平台;
具有整形后的平顶光,能量分布更均匀;
基于windows用户界面;
支持两种作业模式:半自动,手动;
表面活化常温键合
-

WHB-X-100系列Hybrid Bonding键合机
应用场景:
晶圆级键合封装,适用于图像传感器(CIS)、高端处理器、高带宽内存(HBM)的生产制造
具有EFEM物料传输系统;
具有高精度的机器视觉对准系统;
高精度纳米运动台;
Plasma等离子活化单元;
基于windows用户界面;
支持两种作业模式:半自动,手动;
板级封装系列
-

PLB-X-100系列 板级封装键合机
应用场景:
适用于510mm*515mm的板级封装键合产线;
具有EFEM自动化模块,Port口可定制;
传输组件可配置Flip功能(定制Flip工位);
采用外形对准方式;
具有热板烘烤功能;
具有冷台降温单元;
冷热板单元数量可配置;
键合腔单元数量可配置;
控制架构为Windows+PLC双层控制系统;
支持三种作业模式:全自动,半自动,手动;
衍生产品系列
-
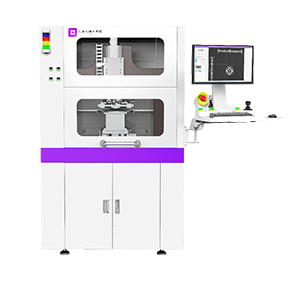
DA-X-100手动贴片设备
应用场景:
适用于各类研究机构,R&D,高校实验室等;
对准精度:±5um@3σ(可选配±2um@3σ);
支持芯片尺寸:5x5mm~60x60mm;
支持基板尺寸:Max:330mm x 250mm;
选配晶圆作为基板;
支持贴合压力:1N~100N;
可根据客户需求定制吸嘴;
可选配上压头加热功能、基板加热功能;
支持三种作业模式:全自动,半自动,手动;